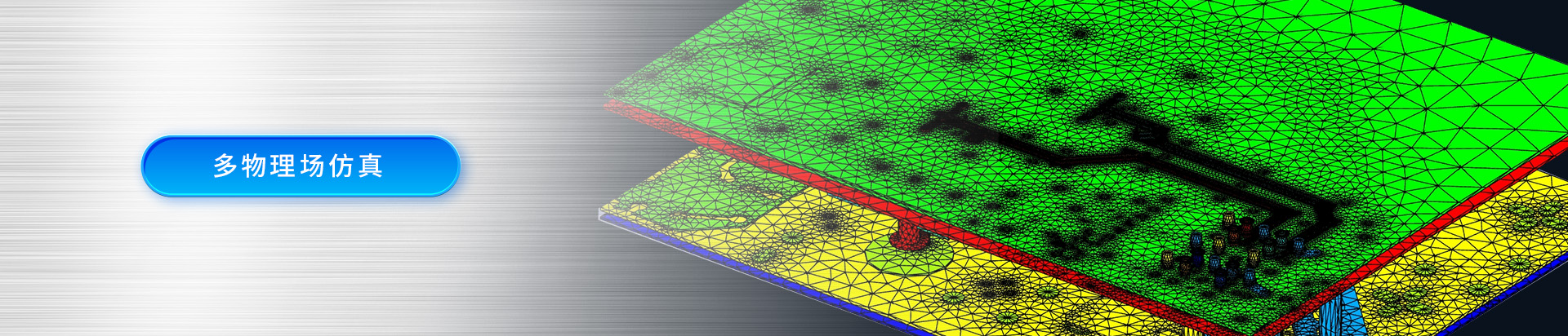
Metis——三维封装和芯片联合仿真软件
产 品 介 绍

Metis是芯和半导体面向2.5D/3DIC Chiplet先进封装设计的仿真平台,可应用于裸芯片、倒装BGA(FCBGA)、晶圆级封装(Wafer Level package)、多Chiplet(Multi-Chiplet)、2.5D/3D先进封装的电磁场分析以及Chip+Package的联合仿真。Metis三维全波高精度电磁仿真引擎可以满足异构集成中对信号和电源建模的效率和精度要求,并支持纳米到厘米级别的跨尺度仿真。
先进封装的电磁场建模需要考虑精度、效率和易用性。Metis是基于矩量法的电磁场工具,可以精准表征导体趋肤效应和邻近效应。智能化的混合网格和自动网格Tunneling技术既满足了对精度的要求,同时又能控制网格规模,给大规模封装设计电磁场提取提供了可能。相比传统方法,Metis对各种封装结构的计算速度和内存具有很大的优势。
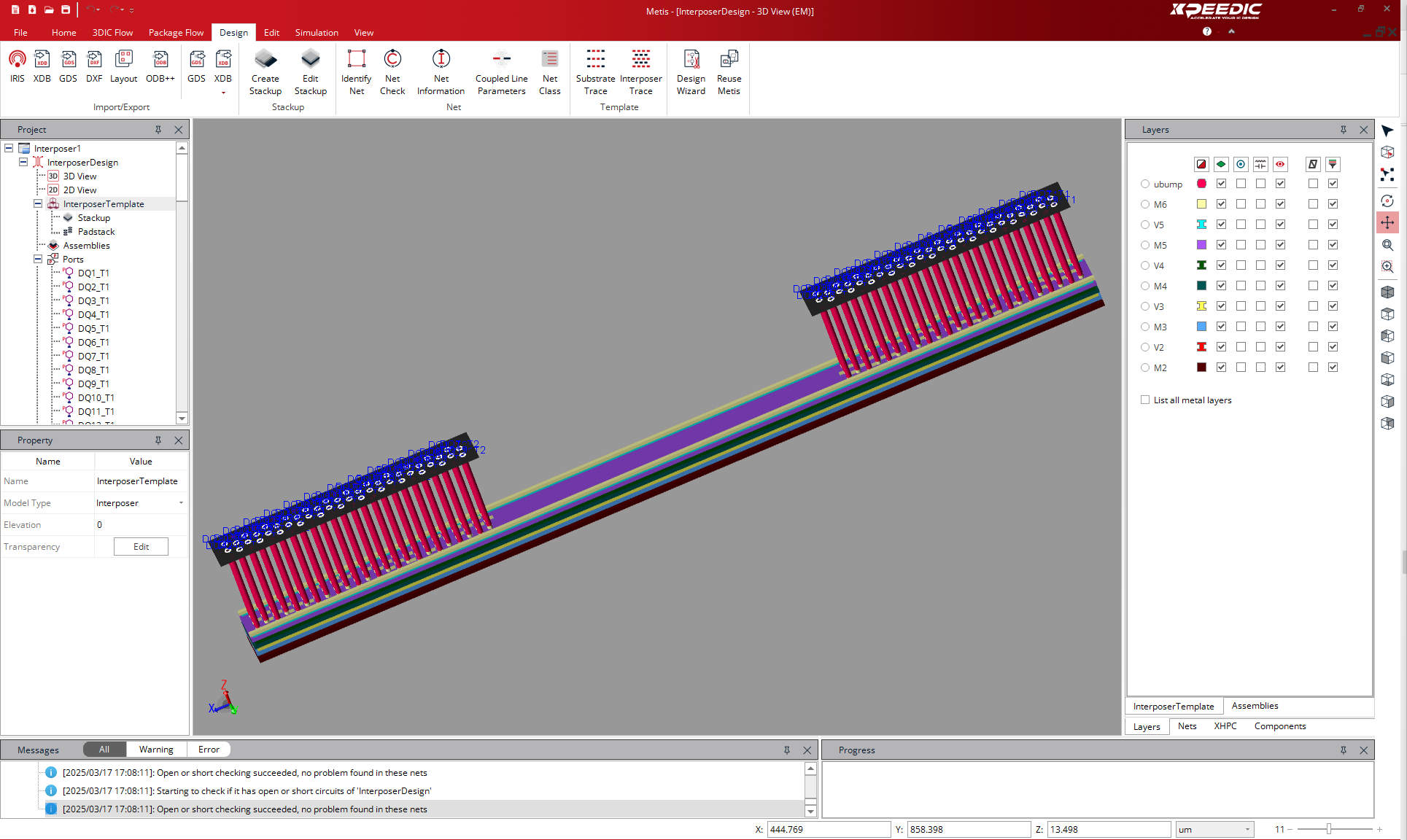
主 要 功 能 
操作简单快捷,支持完备的多场景仿真流程选项:目前Metis已支持信号EM、电源DC、电源AC和信号瞬态仿真流程,并且支持多流程间相互切换,无需二次导入模型,在流程内可一站式完成模型导入、模型编辑、仿真设置和结果展示。
可视化操作,支持主流格式设计导入:支持*.gds、*.brd、*.mcm、*.sip、*dxf和ODB++等主流格式设计文件导入,拥有强大的二维和三维结构查看功能,便于用户在仿真前查看结构进行端口和编辑等操作,并且允许任意切割版图对关注区域进行仿真。
支持各种先进封装场景电磁场分析:可以快速、准确地求解提取信号/电源网络模型参数。结合内置3DIC和Package的仿真Wizard流程与多设计堆叠功能,轻松完成2.5D/3D先进封装建模和信号S参数、时域眼图、电源DC压降和AC阻抗仿真分析。
超大规模异构集成封装高速高频应用仿真,跨尺度电磁分析:采用卓越的矩量法MOMSolverPlus求解器和智能化的网格剖分技术,平衡了几何模型完备性与求解规模复杂度,满足超大规模异构集成封装高速高频应用仿真需求, 并支持纳米到厘米级别的跨尺度电磁分析。
灵活的仿真模式和高效的多任务多核多机并行求解:内置三种仿真模式Speed/Balanced/Accuracy分别对应不同的仿真精度和效率,仿真模式和求解模型类型配合将复杂的网格划分、模型前处理和仿真参数设置等预先定义,帮助用户实现最佳的精度-速度权衡,满足了从架构探索到最终签核的各个设计环节对仿真效率不同需求。支持多任务多核多机并行求解,有效加快仿真速度。
简单易用的多设计堆叠功能,帮助完成多设计模型合并:支持通过Bump、Wirebond和Hybrid Bonding结构将上下两个Die互联,也支持多Die介质和金属合并方式互联建模,同时可以对模型进行翻转、旋转和镜像等编辑操作,构建的模型支持信号通道电磁仿真以及电源网络DC/AC特性分析。
自定义布线、走线分析:支持无版图的前仿真设计分析流程,集成丰富的封装传输线和Interposer模板,用户根据Interposer模板自定义布线形式,自定义模板自动生成Metis工程,并自动定义信号端口,轻松进行Interposer走线分析,提取S参数并自动计算Rdc、C、 IL、 RL、 PSNEXT和PSFEXT结果。


